



纳米尺寸特征以及新材料(包括高K栅极电介质、金属栅极、带状工程、硅化镍和低K隔离电介质)的引入,促使人们需要提高现有计量方法的效率,并探索和实施更多分析技术,以支持下一代技术的制造工艺。不断缩小的器件特征使得许多常规测量和分析超出了扫描电子显微镜 (SEM) 的分辨率极限。
TEM是一种在高空间分辨率下进行微结构分析的强大工具,但早期在半导体行业的应用受到限制,原因是很难制备出特定位置的TEM样品。使用FIB及SEM-FIB仪器来制备特定区域的TEM样品,极大的推动了TEM在半导体行业中的应用。
先进的SEM-FIB具有高分辨率且无漂移的离子和电子束镜筒,可在离子束加工模式下,同时利用电子束对切片进行同步成像。TEM样品制备技术的进步,推动了TEM在集成电路(IC)中的分析应用,这些应用包括工艺开发、产量提高和失效分析。
在TEM中,高能量(100-300kev)电子束穿过样品的薄片,在样品下方形成图像。与SEM图像不同,TEM 图像包含样品薄片的厚度信息。图像中的对比度变化是 TEM复杂的束-样品相互作用的结果。对比度对样品的化学成分、结构和形貌特征的微小变化也很敏感,人们利用这一特性用来分辨晶体缺陷和界面层的微妙影响。此外,高能电子束的波长较小(在200keV时为0.0025 nm),TEM 的分辨能力本质上优于SEM。
二氧化硅薄层被广泛用作MOS晶体管的栅极介电材料,以隔离栅极与源极/漏极沟道。如今,这种栅极介电材料(SiO2或SiON)的物理厚度在1.5-2.0nm之间。精确测量栅极氧化物厚度是必要的,因为即使氧化物厚度减少0.1nm,也会导致漏电流增加一个数量级。
目前正在开发相对较厚的高介电常数(高K)绝缘体,以取代 MOSFET 中的二氧化硅,从而获得高栅极电容并抑制隧道效应。高分辨率透射电子显微镜(HRTEM)被认为是精确测量薄层的最终方法,因为硅衬底中存在的晶格条纹为校准提供了标准。
将应变硅应用于传统 MOSFET 器件与现有的主流 CMOS 工艺技术兼容,但对晶片质量的监控以及对薄膜形态和应变均匀性的严格要求对材料表征提出了新的要求。薄膜应变可通过会聚束电子衍射 (CBED) 技术或测量 HRTEM 图像二维快速傅立叶变换 (FFT) 最大峰值位置的微小移动来确定。
除了半导体工艺表征的需求外,半导体器件故障分析对TEM的需求也在一直增长 。故障分析中最重要的步骤是缺陷的物理和化学特征描述。通过对电学分析确定的故障点进行物理检测,可找出故障的根本原因。
物理检测和化学组成描述可通过SEM或TEM进行。在SEM中,电子束在芯片表面扫描,通过记录二次电子或背散射电子形成图像。图像中观察到的对比度变化通常是表面形貌变化或扫描区域平均原子序数差异的结果。在大多数情况下,对于不改变表面形貌的缺陷(如位错等晶体缺陷)或位于表面以下的缺陷,没有办法获得有用的信息。
在大多数情况下,有必要进行装饰性蚀刻来改变缺陷的形貌,以便使用SEM进行识别。装饰蚀刻是一种破坏性工艺,会妨碍进一步的化学分析。即使在装饰性蚀刻后,SEM也无法分辨先进的技术制造的大多数特征和界面层(尺寸为几纳米)。这些超出SEM分析范围的缺陷和界面层可通过TEM进行表征,以了解故障的根本原因。
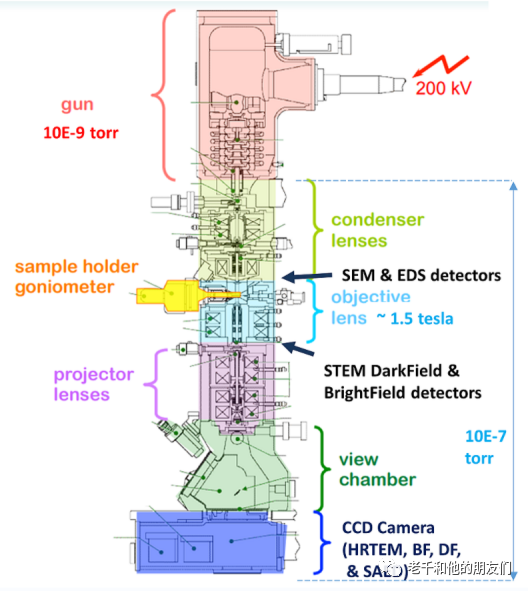
在TEM中,图像是通过高能量(100-300kev)电子束穿过样品薄片形成的。当电子束穿过薄片时,会发生各种电子束与试样的相互作用,产生透射电子、弹性和非弹性散射电子、X射线光子和Auger电子。大部分透射电子、弹性散射电子和部分非弹性散射电子用于形成图像。X射线光子和一些非弹性散射电子与散射体积的化学成分有关。这些 X射线光子和非弹性散射电子分别利用能量色散谱(EDS)和电子能量损失谱(EELS)进行元素分析。图1是TEM中成像平面、EDS和EELS 的物理位置示意图。
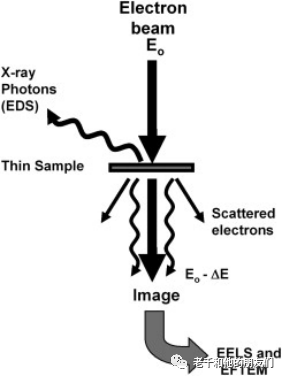
对于晶体样品,在平行电子束的照射下,弹性散射的电子束被分成一个透射束和几个衍射束。切换到衍射模式后,这些电子束的图像便可在TEM中轻松记录下来,这是所谓的衍射图样。选区电子衍射是通过选区孔径选择样品的一个区域来实现的。如果将平行入射电子束换成会聚电子束,衍射光斑就会放大成会聚束电子衍射(CBED)盘。
单晶材料和多晶材料可分别获得光斑衍射图样和环形衍射图样。每个点或环对应样品中的一组晶体平面。任何光斑或环与中心(000)(或透射)光斑的间距都与该光斑或环对应的晶体学平面间距d成反比。斑点和环状图案常用于鉴定样品中各种相的晶体结构。
TEM 图像通过透射束(中心光斑)或任何散射束形成。在物镜的后焦平面上插入一个光阑,从而阻挡了大部分衍射图样。外部电机驱动用于移动光阑,使直射电子或部分散射电子通过光阑。若选择直射电子束,得到的图像称为明场图像;若选择散射电子束,得到的图像称为暗场图像。
大多数半导体器件都是在单晶硅片上制造的,硅片的法线]方向,在这样的硅片上,[110]方向平行于硅片平面或缺口,位于(111)面(裂隙面)上,垂直于[001]方向(垂直于硅片表面)。在电子束平行于硅衬底[110]方向的情况下,记录的横截面图像可确保与器件特征垂直,并消除薄样品投影图像中各种器件特征的重叠。因此,大多数硅器件的横截面图像都是沿[110]方向记录的。
TEM图像中的对比度主要由三种不同的机制形成,即衍射对比度、厚度-质量对比度和相位对比度。经验比较丰富的TEM分析师可以优化各种对比机制的贡献,以成像缺陷的微妙影响。这些对比度的机制描述如下。
在实际应用中,通过物镜后焦平面的物镜孔截取衍射图样,只允许透射束形成图像,从而获得衍射对比度。图像显示了所选电子束离开样品时的强度变化。
衍射对比度对样品的晶体取向和厚度变化极为敏感。在晶体材料中,由于缺陷周围的弹性应变,晶体缺陷周围区域的衍射与完美区域不同,因此导致图像中的对比度变化。位错、堆叠断层和其他晶体缺陷会使晶面弯曲,并由于衍射对比度而在图像中清晰显示。
在多晶硅或氮化钛等多晶材料中,相邻晶粒相对于电子束的取向变化会导致衍射对比度的变化。在半导体失效分析中,衍射对比有助于分辨设备各部件的微观结构,如多晶硅层和串线(stringers),或可能会引起电开路或短路的界面特征。
TEM光学系统的另一个很有用的功能是利用选区电子衍射技术将衍射与成像相结合。之所以能做到这一点,是因为电磁透镜的焦距可以方便快捷地改变。这种选区电子衍射技术在使图像对比度与衍射条件相关联方面具备极其重大价值,特别是对晶体样品而言。
不同厚度的样品对电子的散射、衍射和吸收程度不同,因此导致对比度的变化,即厚度对比度。在质量对比的情况下,强度变化绝大多数都是样品中存在的元素散射能力的映射。质量对比能够给大家提供具有原子分辨率和成分灵敏度的图像。较轻的元素吸收的电子较少,而较重的元素吸收的电子较多。质量对比度与设备的晶体结构无关,可用于分辨多个非晶体薄层,如氧化硅、氮化硅和氮氧硅。
相位衬度用于获得高分辨率TEM图像,可用于精确测量关键器件尺寸,如极薄栅极氧化物的厚度。
高分辨率晶格图像是由透射束和衍射束之间的干涉形成的。如果在物镜孔中对称地包含三束或更多与透射束不共线的强衍射束以形成图像,则会观察到两组或更多相交的平行条纹。这样的图像将呈现与衍射束相关的平面间距相对应的二维周期性图像,在某些情况下可能类似于沿其方向投射的极薄晶体的结构图像。
相反,图像中二维周期图案的傅立叶变换将产生带有衍射图案光斑的图像。通过与已知物质的衍射图样作比较,并经过测量平面间距,可利用傅立叶变换图像中的斑点来识别材料。

扫描透射电子显微镜(STEM)是传统TEM成像技术的一种很有用的补充技术。在STEM中,会聚的电子束聚焦到试样上,然后对试样的一个区域进行扫描。试样下方的探测器收集透射电子。图像显示在阴极射线管 (CRT) 上。放大倍数由扫描区域的大小与显像管的大小之比决定。与传统的TEM相比,STEM具有一些优势,例如更容易解读,能够正常的使用较厚的试样。
与传统的 TEM 相比,STEM在半导体缺陷分析方面具有一些优势,例如更容易解释和可使用相对较厚的样品,因为它不易受色差的影响。STEM 在 TEM 中的工作原理图如图2所示。图像能够最终靠收集透射电子(即STEM明场 (BF) 成像)形成,也能够最终靠使用环形探测器收集散射电子(即STEM环形暗场 (ADF) 成像)形成。

图2 TEM中STEM模式的示意图。以高角度散射的电子被环形检测器捕获以形成Z对比度图像。捕捉x射线光子以形成STEM–EDS元素图。明场探测器从透射束的路径上收回,用于 STEM-EELS检测。
环形探测器通常安装在 TEM 镜筒的指定端口,高度固定。在多晶材料中,BF和ADF图像的对比度主要受电子衍射效应的影响。能调整TEM的电子光学透镜,选择性地将高角度(大于50mrad)散射的电子投射到环形检测器上。这种技术通常称为高角度环形暗场(HAADF)STEM成像。
HAADF图像的对比度对小电子探针下原子柱的质量变化非常敏感。在配备了场发射源的先进TEM中,样品上方的电子透镜可以对准形成一个小探针,由此产生原子分辨率图像。
HAADF 成像也称为 Z对比成像,其中Z为原子序数。当电子束穿过样品时,重原子量元素会散射更多的电子,在HAADF图像中显得更亮。图3显示了BF、ADF和HAADF图像的示例。
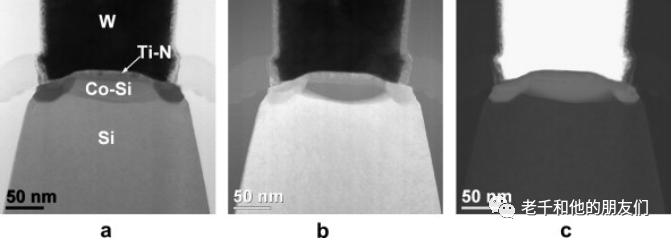
图3W/TiN/Co-Si/Si叠层的STEM图像。(a)明视场(BF),(b)环形暗场(ADF)和(c)高角度环形暗场(HAADF)
配备场发射源的 TEM 具有小束斑的高亮度电子束,可对厚度小于几百埃的区域进行高空间分辨率(约1 nm)的元素分析。TEM 的元素分析技术是利用电子束穿过样品时发生的非弹性散射(能量损失)事件,这两种常用技术是EDS和EELS。
在EDS中,主要是收集电子入射到样品上时各种元素发出的特征X射线。一种元素产生的特征X射线非常容易被同一体积中的另一种元素吸收。因此,该技术的灵敏度取决于检测到的元素和元素的体积组成。
要进行准确的定量结果,需要已知成分的参考样品。使用最先进的超薄或无窗探测器,只要在分析的体积内存在合理数量的原子,就能检测到低至硼的元素。在半导体工艺开发和故障分析中,EDS 分析用于确定缺陷中存在的各种元素,从而找出问题的根源。
如前所述,高能电子束(100-300kev)在穿过样品时会发生非弹性散射。在非弹性散射过程中,透过的电子会失去元素特有的能量。因此,透过的电子束由一系列不同能量的电子组成。
在电子能量损耗谱(EELS)中,TEM 镜筒下方的EELS用于检测具有元素特征的能量损耗电子。EELS由扇形磁铁和检测系统组成。扇形磁铁(图 4)将传输的电子束偏转90度。在此过程中,不同能量的电子在不同程度上受到磁场的偏转。最后,这一过程会产生电子能量损失谱。
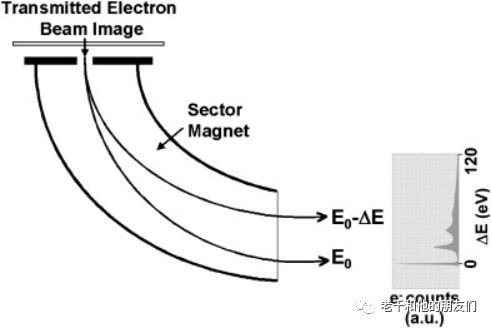
与EDS相比,EELS具有更高的空间分辨率(1 nm)和轻元素(如 C、O 和 N)检验测试能力。为了能够更好的保证结果的准确性,建议使用厚度≤50 nm的样品和无漂移的相干电子源(如场发射电子枪)。
在STEM模式下,TEM可用于记录试样的能量图像。能量信息表现为来自试样不一样的区域的X射线的能量,或来自试样不一样的区域的透射电子的能量损失。这些信号蕴含着丰富的样品元素和化学信息。STEM-EDS、STEM-EELS和能量过滤TEM(EFTEM)技术能在能域中对试样进行成像。
在STEM-EDS中,X射线信号是从STEM扫描的区域收集的。扫描区域可以是线形(线扫描),也可以是矩形(区域扫描)。EDS系统处理并存储数据。输出结果能是X射线信号强度图,也可以是元素分布图。
在STEM-EELS中,透射电子被EELS谱仪收集。同样,线扫描和区域扫描都是可能的扫描模式。EELS系统处理并存储数据。结果可显示为强度图或元素图。
EFTEM是传统TEM成像的延伸。传统TEM无法利用非弹性散射电子的信号。然而,这些信号对微米和纳米分析工作很有用,因为它们形成的电子能量损失谱(EELS)包含化学成分、电子特性和化学键的信息。在 EFTEM 中,只有通过能量过滤器的电子才能形成图像。这样,不允许通过过滤器的能量电子就不会参与图像的形成。只有在TEM上安装EELS谱仪,才能用EELS的信息。
能量过滤器有柱内和柱后两种型号,可从不同供应商处购买。过滤器参数,如能量值、能量窗口等,均由操作人员设置。EFTEM 很适合用于半导体器件的结构分析。钨触点的EFTEM图像应用实例如图5所示。
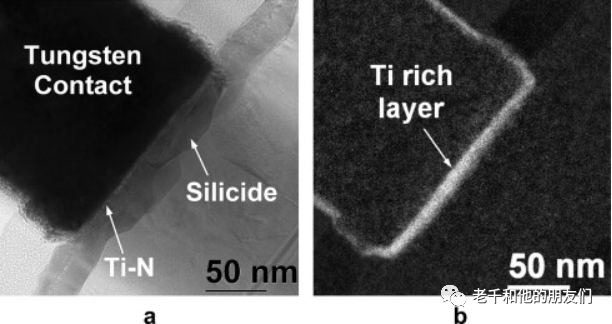
电子断层扫描使用软件重新组合以不同倾斜度记录的一系列STEM图像或 EFTEM 图像,以重建器件或缺陷的三维结构或组成。Stegmann等人展示了应用该技术表征阻挡层Ta/Cu种子层堆栈(seed layer stack)的情况。
晶体管结构中注入离子(As、P和B)的空间分布对于性能优化很重要。离轴电子全息技术是一种可用来绘制高空间分辨率超浅注入离子二维图谱的技术。
定性的二维掺杂剖面图已有报道,但定量的剖面图绘制并不是特别容易。当相干电子束或 平面电子波 照射透明的电子薄样品时,掺杂剂产生的静电势会引起电子波的局部相移。相位调制是 p-n 结上静电势分布的函数,能够最终靠电子全息技术记录下来。Vogel 等人已将电子全息技术应用于识别浅 p-n 结中的缺陷。
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
从娱乐产品、通信设施、交通系统,到节能应用和医疗保健设备,在这些彻底改变我们的日常生活方式的全新应用领域中,
或将迎来复苏的第一缕曙光。ARM CEO伊斯特说,他预计智能手机在2012年将有显著的增长,但也承认
`苏州赛尔科技有限公司,是一家致力于研究、生产、开发和销售于一体的高科技公司,专门为
、日本等国家和组织启动了至少12项研发计划,总计投入研究经费达到6亿美元。借助各国***的全力支持,自从1965年第一支GaAs晶体管诞生以来,化合物
很“远”,而现在,随着家电应用市场和功能的扩展,花了钱的人家电产品的质量和
的趋势是什么?在当前科技日新月异、需求层出不穷的背景下,芯片厂商如何找准自己的定位以不被时代淘汰?近日,EEWORLD记者有幸借助在硅谷举办的euroasia PRESS 拜访Altera
材料中,在商业应用上最具有影响力的一种。芯片芯片(chip),又称微芯片
封装测试工艺 /
基于V18N03-01-LTC3225-Jimdrew直流到直流单输出电源的参考设计
电子技术术语大揭秘:何为电容笔?#凡亿教育 #pcb视频教程免费领取 #电容笔
【中文浓缩】SpaceX星舰助推器静态点火测试后,引擎将送回麦格雷戈测试场
